台积电研制出得3D硅片制造技术,可能会在2022年投产
2020-11-27 11:53 来源: 互联网
据日本媒体报道,目前,高端半导体芯片越来越复杂,封装技术也越来越不满足。各大厂商都在开发各种 2.5D、3D 封装技术。台积电正在中国台湾苗栗市开发 3D 硅片制造技术,预计将于 2022 年投产,首批客户是 AMD 和谷歌。
据报道,英特尔、台积电、三星等公司正在开发 2.5D、3D 封装技术,即不同的 Ip 模块以不同的方式集成在一块芯片上,从而降低了制造难度和成本。
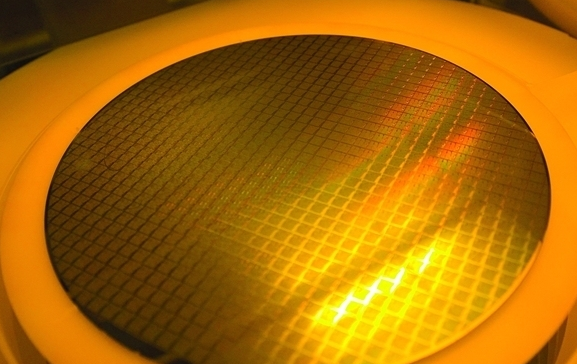
谷歌的产品可能是新一代 TPUAI 计算芯片,AMD 更有可能包括 CPU、GPU、APU、半定制 SoC 等等。
事实上,台积电今年已开始大规模生产第六代 CoWoS 晶片级芯片封装技术,这是一种将芯片和基板封装在一起的技术,是在晶片层面进行的,属于 2.5D 封装技术。此前,AMD 的第一个 HBM 存储器与 2.5D 类似,与 GPU 集成。
当然,英特尔已经发布了自己的 Foveros3D 软件包,它甚至可以堆叠不同进程、结构和用途的芯片,比如房屋。
责任编辑:萤莹香草钟
【慎重声明】凡本站未注明来源为"中国财商新闻网"的所有作品,均转载、编译或摘编自其它媒体,转载、编译或摘编的目的在于传递更多信息,并不代表本站赞同其观点和对其真实性负责。如因作品内容、版权和其他问题需要同本网联系的,请在30日内进行!
热点